自然界的氣體、化學(xué)物質(zhì)和生物分子在其各自的電磁波頻譜中有著獨(dú)特的旋轉(zhuǎn)振動(dòng)模式,對(duì)這些物質(zhì)進(jìn)行分析和監(jiān)測(cè)就要運(yùn)用到太赫茲遙感技術(shù)。太赫茲是頻率單位,等于1,000,000,000,000Hz,通常用于表示電磁波頻率。而目前,制約太赫茲遙感技術(shù)發(fā)展的主要問(wèn)題則是缺少大功率源和高度靈敏的探測(cè)器。而傳統(tǒng)的金屬天線和波導(dǎo)管的輻射率又太低且容易和襯底發(fā)生強(qiáng)烈耦合。對(duì)此,通過(guò)利用氧化硅介電矩陣金屬夾雜的方法研制出了介電常數(shù)很高的新型人工介電層(ADL)。
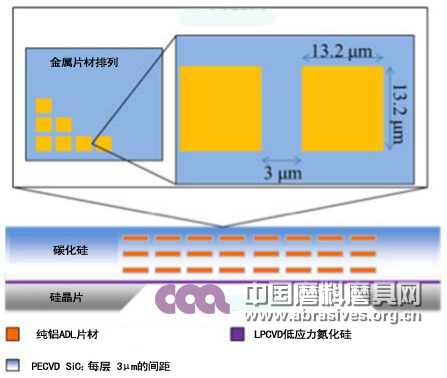
圖一

圖二
由于氧化硅的介電常數(shù)相對(duì)較低(ε=4),對(duì)應(yīng)介電層(ADL)的整體厚度也就比較大,約有5層結(jié)構(gòu)35μm左右。但這樣厚度的介電層其性能明顯受到影響。因此,需要設(shè)計(jì)出更薄的ADL結(jié)構(gòu)。
圖一中,新型的ADL膜是由絕緣片和金屬片交替疊加沉積而成。通過(guò)修整結(jié)構(gòu)的外形,在太赫茲頻率范圍內(nèi)實(shí)現(xiàn)了光學(xué)性能增強(qiáng)型的均勻介質(zhì)。實(shí)驗(yàn)采用等離子增強(qiáng)化學(xué)氣相沉積碳化硅(PECVD SiC)作為介電層,并把該層的折射率調(diào)整在太赫茲頻率范圍之內(nèi)。傳統(tǒng)的集成電路工藝先生產(chǎn)出大量的碳化硅薄膜,然后利用時(shí)域頻譜學(xué)技術(shù)對(duì)其光學(xué)性能進(jìn)行分析;而這種新型的碳化硅ADL膜通過(guò)一種內(nèi)部開(kāi)發(fā)模擬工具對(duì)ADL結(jié)構(gòu)進(jìn)行調(diào)整以實(shí)現(xiàn)在0.8-1.2THz范圍內(nèi)9.9的折射率。
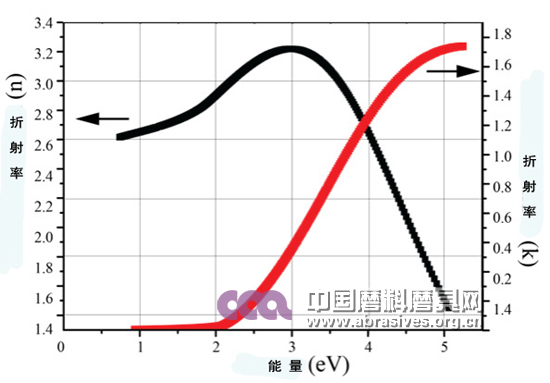
圖三:橢圓分析中250-1600nm范圍內(nèi)PECVD-SiC的折射率
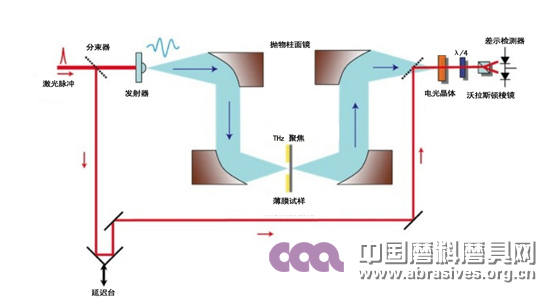
實(shí)驗(yàn)
實(shí)驗(yàn)采用P型100mm的硅晶片來(lái)生產(chǎn)SiC薄膜。首先,在硅晶片上沉淀出一層150nm的低應(yīng)力低壓化學(xué)氣相沉積(LPVCD)氮化硅膜,該層薄膜用于晶片背面的硅濕蝕刻并保護(hù)正面的SiC層,以防止SiC膜沉積過(guò)程中出現(xiàn)彎曲變形和炸裂。然后,使用SiH4和CH4充當(dāng)催化劑,通過(guò)調(diào)整催化劑量,沉積層的應(yīng)力被降至25Mpa,最終利用Novellus-Concept PECVD反應(yīng)器沉積出5mm×5mm大小的SiC膜(如圖二)。實(shí)驗(yàn)采用Tauc-Lorentz色散關(guān)系法利用橢圓偏振光譜來(lái)測(cè)定薄膜的厚度和光學(xué)性能(如圖三)。SiC層沉積完畢后,在85℃的條件下對(duì)背面的氮化硅層進(jìn)行氫氧化鉀濕蝕刻,時(shí)間為5.5小時(shí)。最后將晶片切割,將單個(gè)模嵌入太赫茲時(shí)域光譜測(cè)定儀(TDS)(如圖四)。
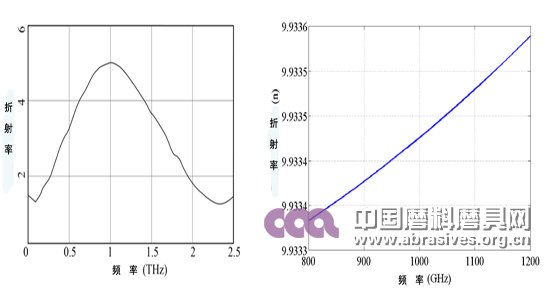
圖五
結(jié)論
實(shí)驗(yàn)采用TDS(太赫茲時(shí)域光譜儀)測(cè)定SiC的折射率,詳細(xì)過(guò)程如圖四所示。赫茲波束從短激光脈沖開(kāi)始,直射GaP電光活性晶體,由此產(chǎn)生的輻射被兩扇拋物柱面鏡接收,然后直射到SiC薄膜上并與SiC發(fā)生反應(yīng),隨后發(fā)出的波束又被收集并直射到探測(cè)器上。圖5(左)顯示了太赫茲頻率下SiC層的折射率,1THz處出現(xiàn)寬峰,最大值為5,這是PECVD SiC的折射率的2.5倍。本實(shí)驗(yàn)的工作頻率為1THz,所有組件都做了對(duì)應(yīng)測(cè)量(圖一)。圖5(右)的模擬顯示1THz時(shí)ADL膜的折射率為9.9。(原作者:G. Fiorentinoa,W.Syedb, A.Adamc, A. Netob and P.M. Sarroa。翻譯:中國(guó)磨料磨具網(wǎng))


 手機(jī)資訊
手機(jī)資訊 官方微信
官方微信







 豫公網(wǎng)安備41019702003604號(hào)
豫公網(wǎng)安備41019702003604號(hào)